 Tata Letak Peralatan MBE Umum, dalam posisi memuat.
Tata Letak Peralatan MBE Umum, dalam posisi memuat.Molecular Beam Epitaxy (MBE) adalah proses fabrikasi material yang digunakan untuk menghasilkan material berskala nano dengan kemurnian tinggi. Suatu bahan tumbuh melalui interaksi antara substrat dan satu atau lebih berkas atom atau molekul yang terjadi pada permukaan substrat. Balok dihasilkan oleh sublimasi bahan sumber padat. Seluruh proses dilakukan di bawah vakum ultra tinggi W. MBE menunjukkan banyak keunggulan dibandingkan proses deposisi film tipis serupa, seperti deposisi uap . Beberapa keuntungannya adalah: kemurnian yang ditingkatkan secara signifikan, resolusi deposisi yang sangat tajam, dan pengoperasian pada suhu rendah.
Isi
Deskripsi sistem
 Tata Letak Aparatur MBE Umum, dalam posisi berkembang.
Tata Letak Aparatur MBE Umum, dalam posisi berkembang.Peralatan MBE utama terdiri dari dua bagian utama: ruang substrat dan sel efusi. Semua bagian harus dievakuasi ke tekanan rendah untuk memastikan kondisi berkas molekul tercapai. Kondisi ini mensyaratkan bahwa jalur bebas suatu partikel lebih besar dari dimensi ruang substrat. Untuk pengaturan MBE tipikal, tekanan 10E-4 Torr sudah cukup, namun tekanan pada urutan 10E-10 Torr biasanya digunakan. [1]
Sel Efusi
 Pandangan aksial sel efusi.
Pandangan aksial sel efusi.Sel efusi adalah sumber berkas molekul. Bahan sumber ditempatkan dalam wadah di dalam sel dan dipanaskan oleh radiasi dari sumber pemanas resistif. Bahan sumber padat menyublim karena peningkatan suhu dan vakum tinggi. Tekanan uap dapat dikontrol dengan memvariasikan suhu fase padat, yang selanjutnya dikontrol dengan variasi pemanasan wadah. Karena intensitas sinar dalam ruang substrat bergantung pada tekanan sel efusi, jumlah material yang mencapai permukaan dapat dikontrol dengan memvariasikan suhu sumber.
Tahap Substrat
Skema ruang media dasar ditunjukkan >. Sel-sel efusi dilekatkan pada ruangan dan diorientasikan sedemikian rupa sehingga mengarahkan sinar ke dudukan substrat. Penahan substrat dipanaskan dengan elemen resistif, seperti pada sel efusi.
Substrat adalah bahan tempat film akan tumbuh. Bahan substrat yang umum adalah silikon, GaAs, dan safir, namun substrat lain dapat digunakan. Pemilihan substrat sangat penting, dan telah terbukti mempengaruhi struktur mikro film tipis. Faktanya, struktur kristal tertentu ditemukan hanya dapat diakses melalui pertimbangan cermat terhadap perilaku substrat. [2] Tahap substrat dapat diputar selama pengendapan untuk meningkatkan homogenitas permukaan.
jendela
Penutup di ujung terowongan kolimasi memungkinkan operator menghentikan fluks material dari setiap sel secara terpisah. Waktu penutupan rana secara signifikan lebih kecil dibandingkan waktu deposisi lapisan tunggal. Artinya komposisi bahan akhir dapat dikontrol pada tingkat lapisan tunggal.
Orientasi daun jendela relatif terhadap arah pancaran sinar penting untuk memprediksi pengoperasian sistem. Sistem penutup tradisional memiliki penutup yang tegak lurus terhadap arah pancaran, secara langsung menghalangi jalur pancaran dan mengarahkan sebagian pancaran ke dalam sel efusi. Namun, metode ini ternyata berdampak buruk pada kontinuitas fluks berkas. [3] Variasi fluks sinar hingga 20% setelah pembukaan dan penutupan rana diamati, dengan waktu peluruhan 30 detik. Variasi ini dapat mengubah komposisi bahan pertumbuhan secara signifikan. Sekarang disarankan agar penutup ditempatkan agak jauh dari sel efusi dan pada suatu sudut, sehingga sinar hanya diarahkan menjauh dari tahap substrat, dan bukan dikembalikan ke dalam sel efusi. Sinar apa pun yang mengenai dinding ruang akan ditangkap, sehingga proses ini menurunkan efisiensi material karena semakin banyak material yang terbuang, namun meningkatkan reproduktifitas dan kontrol terhadap sistem. Keseimbangan antara keduanya bersifat spesifik pada aplikasi dan harus diperhitungkan.
RHEED
Sistem pemantauan RHEED (refleksi difraksi elektron energi tinggi) diterapkan pada peralatan MBE modern. Sistem RHEED digunakan untuk memantau permukaan pertumbuhan selama pengendapan. Elektron berenergi tinggi jatuh ke permukaan, menghasilkan pola difraksi pada layar RHEED. Pola difraksi dapat dianalisis untuk menentukan karakteristik permukaan, seperti struktur material, serta komposisi. Intensitas pola difraksi diketahui bervariasi sesuai dengan pembentukan lapisan permukaan, dan dapat digunakan untuk menentukan kapan lapisan tunggal telah terbentuk sepenuhnya. Informasi ini dapat digunakan untuk mengontrol penutup sel efusi untuk menghasilkan permukaan yang rata secara atom. [1]
Salah satu manfaat lebih lanjut dari peralatan RHEED adalah memungkinkan operator menyelidiki permukaan tanpa memerlukan pandangan langsung ke permukaan. Hal ini untuk menghindari masalah yang terkait dengan tampilan layar pada peralatan UHV. [4]
Prinsip Operasi
Epitaksi berkas molekul adalah proses yang rumit. Pemahaman tentang bagaimana dan mengapa hal ini berhasil, dapat diperoleh hanya dengan memahami prinsip-prinsip dasar teknik material yang mendasari proses tersebut. Ada dua topik utama dalam ilmu material yang mendorong proses MBE: keseimbangan fase dalam sel efusi, dan difusi permukaan pada permukaan pertumbuhan.
Keseimbangan fase
 Diagram fasa untuk sistem fasa tunggal
Diagram fasa untuk sistem fasa tunggalDi dalam sel efusi, proses utama yang mendorong timbulnya fluks adalah kesetimbangan fase uap padat W . Diagram fase umum untuk sistem komponen tunggal ditunjukkan di sebelah kanan. Tekanan di mana proses MBE dilakukan berada di bawah titik tripel (tempat pertemuan tiga garis), dan dengan demikian satu-satunya fase yang ada pada kesetimbangan adalah padat dan uap. Kesetimbangan terpenuhi pada kondisi operasi normal jika sel efusi dirancang dengan benar. Hukum fase Gibb menyatakan
Dimana F adalah jumlah derajat kebebasan suatu sistem, N adalah jumlah komponen kimia yang ada, dan P adalah jumlah fasa yang ada. [5] Dalam sel efusi, terdapat satu komponen kimia dan dua fase. Jadi, hanya ada satu derajat kebebasan, artinya tekanan dan suhu tidak dapat diubah secara independen. Sebaliknya, ini berarti tekanan sel dapat dikontrol dengan mengubah suhu. Suhu dan tekanan berhubungan secara eksponensial, yaituP(T)≈Ce-ΔH/kT{\displaystyle P(T)\kira-kira Ce^{-\Delta H/kT}}


Difusi Permukaan
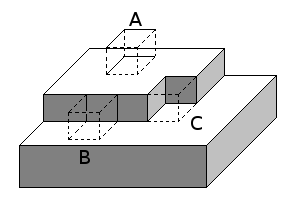
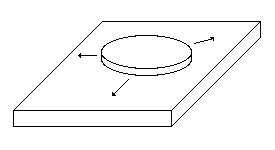
Ketika bahan tumbuh di atas substrat, laju dan jenis pertumbuhan kristal W dikendalikan oleh energi yang tersedia bagi atom. Konstanta difusi W pada permukaan diberikan oleh:
DS=DS0e-Q/kT{\displaystyle D_{s}=D_{s0}e^{-Q/kT}}
Di manaDS{\gaya tampilan D_{s}}

Laju difusi permukaan umumnya lebih besar dibandingkan laju difusi kisi curah. Akan tetapi, luas permukaan suatu material tertentu beberapa kali lipat lebih kecil dibandingkan dengan luas permukaan suatu material, sehingga sering diabaikan dalam pertimbangan difusi. Namun, selama pertumbuhan MBE, sebagian besar kristal dipengaruhi oleh kedekatannya dengan permukaan. Jumlah difusi permukaan yang lebih besar akan meningkatkan laju pertumbuhan, serta kualitas permukaan. Jika atom-atom yang datang dapat bergerak lebih jauh di sepanjang permukaan, kemungkinan besar atom-atom tersebut akan sampai pada keadaan energi terendah dan bebas cacat. Meskipun cacat pembatas lebih disukai secara energetik, karena penurunan energi permukaannya, pembentukan cacat lebih disukai dengan pertimbangan entropis. Untuk mengatasi hal ini, luas permukaan harus dipanaskan secukupnya sehingga energi panas atom-atom yang berdifusi cukup besar untuk menghilangkan cacat.
Meminimalkan energi permukaan merupakan kekuatan pendorong utama pertumbuhan MBE. Ketika sebuah atom tiba di permukaan, jumlah total ikatan atom putus yang terkait dengan permukaan tersebut, dengan kata lain, energinya, meningkat. Atom ini sendiri tidak disukai untuk tetap berada di permukaan, dan kemungkinan besar akan kembali ke fase uap setelah berdifusi di sepanjang permukaan. Jika atom lain tiba di dekatnya, dan keduanya berinteraksi saat berdifusi, jumlah ikatan putus yang terkait dengan kedua atom tersebut berkurang. Penambahan atom ketiga menyebabkan penurunan lebih lanjut energi permukaan. Hal ini menyebabkan terbentuknya "pulau" material di permukaan. Semakin banyak atom yang tiba di dekat pulau, mereka cenderung menuju pulau, sehingga menyebabkan pertumbuhan pulau lebih lanjut.
Atom-atom yang tiba di puncak pulau akan cenderung berdifusi ke luar pulau melewati sebuah langkan. Lompatan ke bawah ini sangat disukai. Jumlah ikatan putus yang diasosiasikan dengan atom di atas pulau lebih besar dibandingkan dengan atom di tepinya. Demikian pula, atom akan berdifusi menuju kekusutan di tepian dibandingkan ke daerah terbuka. Tidak ada ikatan putus tambahan yang diasosiasikan dengan bergabungnya ketegaran tersebut, sedangkan pembentukan bagian langkan baru melibatkan penciptaan banyak ikatan putus baru. Hal ini mengakibatkan tumbuhnya pulau-pulau yang relatif melingkar. Karena lambatnya laju pertumbuhan pada aplikasi MBE, laju difusi melintasi permukaan cukup besar sehingga atom yang mendarat di atas pulau pada lapisan tidak lengkap akan berdifusi ke seluruh pulau, bergabung dengan lapisan tidak lengkap.
Pertimbangan Vakum
Dua alasan terbesar UHV dalam MBE adalah tuntutan akan kondisi pancaran sinar dan minimalisasi kontaminan di atmosfer. Kondisi balok terpenuhi jika tekanan di bawah 10^-4 Torr. Namun, konsentrasi kontaminan permukaan pada tekanan ini tidak cocok untuk pertumbuhan epitaksi dengan kemurnian tinggi. Laju interaksi partikel uap dengan suatu permukaan diberikan oleh:
DNDT=P2πMkT{\displaystyle {\frac {dn}{dt}}={\frac {P}{\sqrt {2\pi mkT}}}}
Dimana dn/dt adalah jumlah interaksi per satuan waktu per satuan luas, P adalah tekanan, m adalah massa partikel, T adalah suhu dan k adalah konstanta Boltzmann. [3] Jika P diambil dalam Torr, dan m diganti dengan M, massa molar, persamaan kedua diperoleh. Dalam kondisi atmosfer standar, pada suhu 25 derajat Celcius dan massa molar uap rata-rata 40 g, laju interaksi berbanding lurus dengan tekanan, sebagaiDNDT=3.2×1020P{\displaystyle {\frac {dn}{dt}}=3,2\kali 10^{2}0P}


Dapat dilihat bahwa laju interaksi juga dapat diturunkan dengan meningkatnya suhu. Namun hal ini tidak efisien. Untuk menurunkan laju interaksi sebanyak 100, tekanan hanya perlu diturunkan sebanyak 100 kali, dan hal ini dapat dilakukan dengan peralatan modern. Untuk mencapai perubahan laju yang sama dengan mengubah suhu, suhu harus dinaikkan 10.000 kali lipat! Meskipun fluktuasi suhu yang besar membutuhkan lebih sedikit energi pada tekanan rendah, perubahan laju interaksi yang diperlukan untuk mencapai sistem yang dapat digunakan akan memerlukan fluktuasi suhu yang terlalu besar, yang akan meningkatkan biaya pengoperasian dan biaya material peralatan. Selain itu, pengoperasian pada suhu yang sangat tinggi ini membatasi bahan yang dapat diproduksi.
Proses Pertumbuhan
Selama pengendapan, satu atau lebih sinar diarahkan ke substrat. Ketika suatu partikel mencapai substrat, ia akan terserap ke permukaan. Tergantung pada substrat dan kondisi permukaan, partikel tersebut kemudian akan bergabung dengan permukaan, atau terdesorpsi dan kembali ke atmosfer. Kondisi penyerapan sangat bergantung pada bahan yang ditumbuhkan dan bahan substrat. Studi kinetika pertumbuhan sangat sulit dalam bidang MBE karena adanya interkonektivitas parameter pertumbuhan (misalnya perubahan fluks sinar juga mengubah atmosfer pada substrat). [1] Masalah lain dalam MBE adalah proses pengendapan tidak berlangsung pada atau mendekati kesetimbangan termodinamika. Suhu berkas molekul biasanya sangat berbeda dari suhu permukaan substrat.
Pekerjaan di MBE telah difokuskan pada produksi zat W yang didoping atau senyawa biner W , seringkali untuk aplikasi dalam semikonduktor W. Dua jenis MBE yang paling umum adalah IV dan III-V. Nama-nama ini sesuai dengan golongan bahan sumber yang ditemukan dalam tabel periodik W . Silikon adalah bahan IV yang paling umum untuk aplikasi MBE, dan sistem GaAs adalah contoh umum dari sistem III-V. [1] Sistem lain (terutama II-VI) dimungkinkan dan telah diselidiki, namun jumlah pekerjaan pada sistem ini sangat kecil dibandingkan dengan sistem IV dan III-V.
Sistem IV
Salah satu fokus utama MBE IV adalah doping silikon untuk aplikasi semikonduktor. Berbeda dengan mekanisme doping berbasis difusi tradisional, MBE memungkinkan pembuatan profil doping yang tajam dan sewenang-wenang. Untuk memproduksi, misalnya, film silikon tipe-n, balok silikon dan fosfor harus digunakan. Fluks silikon harus lebih besar dari fluks fosfor, yang dapat dicapai dengan menyesuaikan jumlah pemanasan dalam sel efusi fosfor. Silikon tipe P dapat diproduksi dengan cara yang sama, dan sambungan pn atau pin dapat diproduksi dengan mengganti balok.
Sistem III-V
Selama pengerjaan awal produksi film GaAs, efek menarik diamati. Koefisien adhesi suatu bahan kimia adalah peluang suatu partikel mencapai substrat yang tersisa pada substrat. Ditemukan bahwa koefisien adhesi partikel III adalah satu. [1] Dengan tidak adanya partikel III, tidak terjadi penyerapan partikel VI. Hal ini mengarah pada kesimpulan bahwa laju pertumbuhan material hanya bergantung pada fluks balok III. Dalam kasus GaAs, molekul As diserap di permukaan, dan bereaksi dengan Ga di permukaan, atau terdesorpsi. Partikel Ga akan terkumpul sebagai tetesan pada permukaan substrat jika tidak ada fluks As yang cukup untuk mempertahankan pertumbuhan. Hasil ini dapat dikaitkan dengan perbedaan perilaku ikatan bahan kimia III dan V, dan energi yang dihasilkan terkait dengan pembentukan permukaan. Untuk Ga, pembentukan antarmuka padat-cair dan cair-uap sangat menguntungkan pada substrat GaAs, dan tetesan pun terbentuk. Proses ini tidak menguntungkan bagi As, sehingga partikel As malah akan membentuk molekul gas (As2, As4). Fenomena ini penting dalam pengembangan film III-V, dan menyoroti salah satu metode yang digunakan untuk mengendalikan laju pertumbuhan dalam proses MBE. Tidak ada fenomena serupa yang terjadi pada partikel IV, yang merupakan salah satu perbedaan utama antara kedua proses pertumbuhan tersebut.
Pertimbangan Efisiensi
Pemilihan Bahan untuk Peralatan
Pemilihan bahan untuk digunakan dalam peralatan MBE dimotivasi oleh lingkungan UHV dan tuntutan akan tingkat kontaminan yang rendah. Bahan apa pun yang dipilih untuk digunakan dalam vakum tinggi harus memiliki tekanan uap yang sangat rendah. Tingkat penguapan yang rendah membatasi kerusakan sistem, namun yang lebih penting, juga menurunkan konsentrasi atom kontaminan di atmosfer. Setiap atom yang meninggalkan wadah penahanan dan mencapai tahap substrat memiliki kemungkinan besar untuk bergabung dengan permukaan sampel dan mengkontaminasi sampel. Persyaratan ini dapat dipenuhi dengan menggunakan logam tahan api untuk peralatannya.
Namun perlu diperhatikan bahwa tidak semua logam tahan api memuaskan. Misalnya, molibdenum memiliki sifat material yang dapat diterima untuk digunakan dalam ruang hampa tinggi, namun tidak dapat digunakan untuk MBE. Karena metode pemrosesan yang digunakan untuk memproduksi bagian molibdenum, sejumlah besar belerang tertanam di dalam bagian molibdenum. Pengotor ini akan berdifusi keluar dari permukaan dan masuk ke atmosfer vakum. Belerang terkenal sebagai dopan untuk semikonduktor. Partikel dopan yang menyimpang dapat mengakibatkan sifat film terganggu, dan semua biaya harus dihindari. Karena alasan ini, tantalum digunakan untuk banyak komponen bejana (misalnya elemen pemanas resistif, penutup sel efusi).
Bahan wadah sel efusi juga harus dipilih dengan hati-hati. Karena wadahnya bersentuhan langsung dengan bahan sumber, dan pada suhu tinggi, reaktivitas dan laju penguapan yang diinginkan sangat rendah. Standar industri cawan lebur sel efusi untuk produksi semikonduktor adalah boron nitrida. [3] [1]
Pemisahan Sistem
Seperti sistem vakum lainnya, peralatan MBE harus diberi tekanan sesekali untuk pembersihan dan pemeliharaan. Untuk memuat substrat, atau mengisi ulang sel efusi yang kosong, seluruh peralatan juga harus diberi tekanan. Setiap kali peralatan dikembalikan ke tekanan atmosfer, sistem diisi ulang dengan kontaminan. Dalam hal efisiensi proses, semakin jarang suatu bagian sistem diberi tekanan dan kemudian dikembalikan ke kondisi vakum, maka semakin baik. Salah satu solusi untuk masalah ini di MBE adalah melalui segregasi sistem.
Sistem MBE modern dibagi menjadi setidaknya dua ruang berbeda: satu ruang tempat pertukaran substrat, dan ruang lainnya tempat bahan ditanam. Hal ini memungkinkan pemuatan dan pembongkaran media tanpa masalah tekanan yang terkait. Saat media baru dimasukkan, hanya ruang pertukaran media yang jauh lebih kecil yang perlu dikembalikan ke ruang vakum, sedangkan ruang pertumbuhan tetap pada UHV. Pemotongan tambahan populer lainnya adalah mengisolasi sel efusi. Hal ini akan memungkinkan operator untuk mengisi ulang sel efusi yang kosong tanpa memberikan tekanan pada ruang pertumbuhan, dan bahkan tanpa menghentikan proses pertumbuhan, jika sel lain juga beroperasi. Mengurangi jumlah langkah pemberian tekanan akan mengurangi waktu pemrosesan dan meningkatkan kemurnian sampel secara signifikan.
Surfaktan
As mentioned previously, film growth during MBE is driven by surface diffusion. The rate of film growth can be increased by increased the rate of surface diffusion. One method to achieve this is by increasing temperature. The only other way to increase diffusion is by reducing the pre-exponential diffusion coefficient.
One group has shown success in increasing system mobility at low temperatures in the epitaxial growth of GaAs by the use of a hydrogen flux acting as a surfactant.[6] By directing a beam of atomic hydrogen toward the surface of a GaAs film being grown by MBE, the process temperature could be dropped from 600 degrees Celsius to 330 degrees without any drop in film quality. The mechanism is believed to be related to hydrogen atoms bonding with surface arsenic atoms, which greatly decreases the surface energy and increases the mobility of gallium atoms along the surface. The hydrogen atoms were then displaced by the gallium atoms to form an almost perfect layer.
Another benefit of the hydrogen flux was its surface cleaning effect. The hydrogen atoms, which have no detrimental effect on the film end product, displaced possible surface contaminants. The increased pressure near the substrate surface caused by the hydrogen flux would push other atoms out of the way, increasing surface quality. The additional flux can also be used to cool and clean the film at the end of the processing step.
Heating
Traditional radiative heating methods in MBE have been successful. A number of improvements have been implemented.
- Shielding the substrate heating apparatus with a multilayer (usu. tantalum) shell to reduce lost radiant energy[7][8]
- Varying the shape of the resistive element to optimize performance[7]
- Use of electron beam heating in the effusion cells to use higher lower vapour pressure materials[1]
- Use of diffuse lasers to heat substrate stage, which enables high temperatures to be reached in low times (temperature increase of 800 Kelvin in under 200 seconds); heating is very localized, decreasing the out-gas potential[9]
Patents
MBE has been researched for several decades, and many advances have been made to the basic apparatus. A large number of patents have been issued for improvements to the apparatus. Some of the improvements include:
- enhancements to the shutter system to enable arbitrary flux variations[10]
- readily removable effusion cell crucibles to avoid system shut-down during refilling[10]
References
- ↑ Jump up to: 1.0 1.1 1.2 1.3 1.4 1.5 1.6 1.7 Ledentsov, Nikolai N. Growth processes and surface phase equilibria in molecular beam epitaxy. New York: Springer, 1999.
- ^ Lin, W. dkk. Pertumbuhan epitaksi berkas molekul zinc-blende FeN(111) pada wurtzite GaN(001). Jurnal Paduan dan Senyawa. 463.2007.
- ^Lompat ke:3.0 3.1 3.2 Arthur, John. Epitaksi Berkas Molekuler. Ilmu Permukaan. 500.189-217. 2002.
- ^ Casel, A. dkk. Kontaminasi boron pada permukaan silikon yang dipanaskan di tempat. Jurnal Sains dan Teknologi Vakum. 5(6). 1987.
- ^Lompat ke:5.0 5.1 Porter, DA dan Easterling, KE "Transformasi Fase pada Logam dan Paduan." Edisi ke-2. Grup Taylor & Francis, 1992.
- ^ Okada, Y. dan JS Harris, Jr. Analisis dasar mekanisme pertumbuhan skala atom untuk epitaksi berkas molekul GaAs menggunakan atom hidrogen sebagai surfaktan. Jurnal Sains dan Teknologi Vakum. 14(3). 1725-1728. 1996.
- ^Lompat ke:7.0 7.1 Shengurov dkk. "Pemanas Substrat untuk Vakum Sangat Tinggi." Instrumen dan Teknik Eksperimental. 47(5). 2004.
- ^ Kiyama, H.et. Al. "Peralatan Epitaksi Berkas Molekul Sumber Gas." Paten AS 5252131. 12 Oktober 1993.
- ^ Ohashi, S.dkk. "Sistem epitaksi sinar molekul laser kompak menggunakan pemanasan laser pada substrat untuk pertumbuhan film oksida." Review Instrumen Ilmiah. 70(1). 1999.
- ^Lompat ke:10.0 10.1 Mattord, Terry J. "Sel Efusi Epitaksi Berkas Molekul." Paten AS 6011904. 4 Januari 2000.

