Introduction
The focused ion beam (FIB) microscope[1] has gained widespread use in fundamental materials studies and technological applications over the last several years because it offers both high-resolution imaging and flexible micro and nanomachining in a single platform. Focused Ion Beam (FIB) techniques are used in a variety of applications. In terms of failure analysis, FIB techniques are commonly used in high magnification microscopy, die surface milling or cross-sectioning, and even material deposition[2].
Background on FIB
Texts available in the MOST library
- User's Guide to Ellipsometry by H.G. Tompkins
- Spectroscopic Ellipsometry Principles and Applications by Hiroyuki Fujiwara
- Spectroscopic Ellipsometry notes by R.W. Collins
Equipment
| Hitachi FB-2000A FIB |
|---|
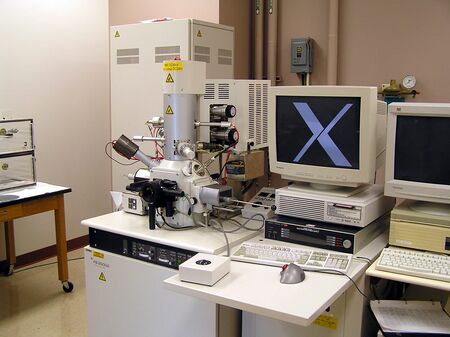 |
The Hitachi FB-2000A FIB uses a beam of focused high-energy (30 kV) gallium ions to remove material in a very controlled manner from inorganic specimens. The FB-2000A is a single beam system; that is, users image the specimen with the same beam used for milling. The column resembles that of an electron microscope and functions very much the same. Control of the ion beam is gained through the Unix workstation and fabrication software system that is designed to support both TEM sample preparation and pattern milling[3].
Hitachi_FB-2000A_Focussed Ion Beam (FIB) Specifications
Hardware Description Our equipment has the following major hardware;

